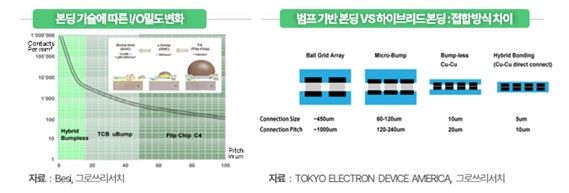
[서울=뉴시스] 배요한 기자 = 인공지능(AI) 반도체 수요 폭증으로 고대역폭·고집적·고효율 패키징이 핵심 경쟁력으로 부상한 가운데, '하이브리드 본딩'이 기술의 패러다임을 뒤바꿀 게임체인저로 주목받고 있다.
한용희 그로쓰리서치 연구원은 24일 "반도체 미세화가 물리적 한계에 다다르면서 성능 향상의 열쇠가 후공정으로 넘어오고 있다"며 "AI 시대 요구에 부합하는 새로운 패키징 기술로 하이브리드 본딩이 급부상하고 있다"고 말했다.
이어 "기존 선폭 미세화는 2㎚이하에서 수율 저하, 설계 복잡도, 공정 비용 급증 등으로 한계에 봉착했다"며 "칩렛·헤테로지니어스 통합 등 대안 기술도 전력 효율과 통신 거리 측면에서 제약이 컸다"고 설명했다.
기존 범프(Bump) 기반 본딩은 I/O(입출력) 수 증가를 위해 간격을 줄이는 방식으로 진화해왔지만, 약 20㎛ 이하로 축소되면 쇼트 불량이 급증해 기술적 한계에 부딪쳤다. 하이브리드 본딩은 범프 없이 구리-구리를 직접 접합함으로써 이론상 1㎛ 이하의 pitch 구현이 가능하다고 한 연구원은 설명했다.
HBM4(6세대 HBM)는 I/O 수를 2048개로 두 배 확장하면서 하이브리드 본딩을 채택해, 해당 기술의 실효성과 필요성을 입증했다.
다만, 하이브리드 본딩 기술은 '전공정 수준의 후공정’'라 불릴 만큼 까다로운 제조 환경을 요구한다. 이에 따라 초기 시장은 전공정 기술 역량을 보유한 기업이 주도할 가능성이 높다는 분석이 나온다. 실제로 SK하이닉스는 최근 HBM3 12단 하이브리드 본딩 패키지 테스트에 성공하며 기술 내재화를 가속하고 있으며, HBM 전용 라인 확장도 추진 중이다.
한 연구원은 "AI 시대는 더욱 빠르고 강력한 데이터 전송을 요구하며, 범프 기반 본딩은 이미 기술적 한계에 도달했다"며 "하이브리드 본딩은 이제 선택이 아닌 필수 기술로 자리 잡을 것"이라고 전망했다.
그러면서 "HPSP는 고압 수소 어닐링 분야에서 독보적 레퍼런스를 갖춘 만큼 필수 공정장비 공급사로 부각되고 있다"며 "한미반도체도 Advanced MR-MUF 기술 기반의 HBM 패키징 노하우를 바탕으로 자체 하이브리드 본더 개발을 통해 차세대 핵심 장비 기업으로 도약을 준비 중에 있다"고 덧붙였다.
◎공감언론 뉴시스 [email protected]





